BGA枕頭效應(head-in-pillow)發生的可能原因
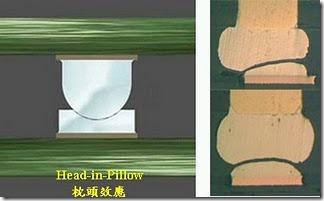
枕頭效應(Head-in-Pillow,HIP)最主要是用來描述BGA的零件在迴流(Reflow)的高溫過程 中,因為BGA載板或是電路板發生板翹(warpage)或是其他原因,使得BGA的錫球(ball)與印刷在電路板上的錫膏分開,當電路板的溫度漸漸冷 卻低於焊錫的熔點後,錫球與錫膏也各自從的熔融狀態凝結回常態,BGA的載板與電路板的翹曲也慢慢的恢復,當錫球與錫膏又再次接觸後,就會形成類似枕頭形 狀的虛焊或假焊的焊接。
|
|
HIP檢測
按照上面的理論,枕頭效應(HIP)大部分都會發生在BGA零件的邊緣,因為翹曲最嚴重,如果是這樣,可以試著使用 顯微鏡或是光纖內視鏡來觀察,但通常只能看到最外面的兩排錫球,再往內就很難辨認了,而且這樣觀察BGA的錫球還得確保其旁邊沒有高零件擋住視線,以現在 電路板的高密度設計,執行起來真的限制很多。 |
 |
目前比較可靠可以分析HIP不良現象的方法是使用染紅試驗(Red Dye Penetration),以及微切片分析(Cross Section),但這兩種方法都屬於破壞性檢測,所以非到必要不使用。
HIP的發生的可能原因
枕頭效應雖然是在迴流焊期間所發生的,但真正形成枕頭效應的原因則可以追溯到材料不良,而在電路板組裝工廠端則可以追溯到錫膏的印刷,貼件/貼片的準確度及迴焊爐的溫度設定…等。底下是幾個形成枕頭效應(HIP)缺點的可能原因:
- BGA封裝(Package)
如果同一個BGA的封裝有大小不一的焊球(solder ball)存在,較小的錫球就容易出現枕頭效應的缺點。
另外BGA封裝的載板耐溫不足時也容易在迴流焊的時候發生載板翹曲變形的問題,進而形成枕頭效應。
(warpage of substrate, inconsistent bump size)
- 錫膏印刷(Solder paste printing)
錫膏印刷於焊墊上面的錫膏量多寡不一,或是電路板上有所謂的導通孔在墊(Vias-in-pad),就會造成錫膏無法接觸到焊球的可能性,並形成枕頭效應。
另外如果錫膏印刷偏離電路板的焊墊太遠、錯位,這通常發生在多拼板的時候,當錫膏熔融時將無法提供足夠的焊錫形成橋接,就會有機會造成枕頭效應。
(insufficient solder paste volume, printing misalignment)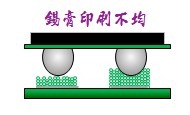

- 貼片機的精度不足(Pick&Place)
貼片機如果精度不足或是置件時XY位置及角度沒有調好,也會發生BGA的焊球與焊墊錯位的問題。
另 外,貼片機放置IC零件於電路板上時都會稍微下壓一定的Z軸距離,以確保BGA的焊球與電路板焊墊上的錫膏有效接觸,這樣在經過迴流焊時才能確保BGA焊 球完美的焊接在電路板的焊墊。如果這個Z軸下壓的力量或形成不足,也有機會讓部份焊球無法接觸到錫膏,而造成HIP的機會。
(Inaccurate XY placement, insufficient placement force)

- 迴流焊溫度(Reflow profile)
當迴流焊(reflow)的溫度或升溫速度沒有設好時,就容易發生沒有融錫或是發生電路板及BGA載板板彎或板翹…等問題,這些都會形成HIP。 可以參考BGA同時空焊及短路可能的原因一文,瞭解BGA載板與電路板因為CTE的差異過大,以及TAL(Time Above LIquidous)過長,而造成的板彎板翹所形成的BGA空焊及短路的分析。
另外,要注意預熱區的溫度升溫如果太快的話容易驅使助焊劑過早揮發,這樣就容易形成焊錫氧化,造成潤濕不良。其次最高溫度(Peak Temperature)也最好不要調得過高及過久,建議最好參考一下零件的溫度及時間的建議。
(inadequate reflow profile that results in component & PCB warpage, LIfting of BGA bumps due to wetting force, Excessive Peak Temperature, too much TAL)
- 焊球氧化(Solder ball Oxidization)
BGA在IC封裝廠完成後都會使用探針來接觸焊球作功能測試,如果探針的潔淨渡沒有處理的很好,有機會將污染物沾污於BGA的焊球而形成焊接不良。其次,如果BGA封裝未被妥善存放於溫濕度管控的環境內,也很有機會讓焊球氧化至影響焊錫的接合性。
沒有留言:
張貼留言