IC載板
IC載板是PCB印刷電路板的細分,為運用於IC封裝的載體,IC載板內部有線路連接晶片與外在電路板,用以溝通晶片與電路板之間訊號、保護電路與散熱 的功能。IC載板:
IC 基板或稱IC載板主要功能為承載IC做為載體之用,並以IC基板內部線路連接晶片與印刷電路板(PCB)之間的訊號,是介於IC及PCB之間的產業,主要 為保護電路、固定線路與導散餘熱,為封裝製程中的關鍵零件,佔封裝製程35-55%成本,隨晶圓製程技術演進,對於晶圓佈線密度、傳輸速率及訊號干擾等效 能需求提高,使得IC基板需求逐漸增加。
在製程上(1)IC基板(載板)的線寬線距,多數都會小於甚至遠小於PCB;(2)厚薄上,IC載板也會比較薄一點,而 且層數較低;(3)線路銅厚上,IC載板也會較低;(4)在solder mask製作時,IC載板的SMT Pad是solder mask define,而PCB 則是non-solder mask define。
除 了製程上的差異,在用途上,PCB的用途太廣了,最常被講的就是桌上型電腦(desktop)或是筆記型電腦(laptop或notebook)的主機 板,但是不只這些,你想的到的電子產品,不管複雜或是簡單,都需要PCB來讓它運作,記憶卡(SD、MMC、xD..)、手機、PDA、MP3隨身聽、大 型伺服器等等,都需要使用PCB來安插電容、電阻、電感與線路導通。舉個圖示,來一片手機板
而 IC載板,則是在晶圓製作完成後,會把晶圓裁切(dicing)成一小片一小片,封裝在IC載板上(可以說是稍微比較小與比較精密的PCB),而封在載板 後,便又有可能進一步把它組裝在更大片的PCB上,當印刷電路板上組裝完許許多多的主動元件(晶片)與被動元件(電容、電阻、電感)後,就成了可以裝在電 腦中、手機中或是任何需要電器中,可以作用的主機板了。
IC基板其實和PCB板有很大的相似性, 但仍有些許不同!
1.IC基板的板材通常不是用 FR4(用BT, G-TEK等), 而PCB 通常是用FR4
2.製程中IC基板通常會有很多的孔, 所以占鑽孔機的時間很長, 很長, 而PCB的孔再多也不太可能有IC基板多, 而且IC 基板的孔都很小個, 所以鑽孔機器通常不同
3.IC基板用水平電鍍線, 而一般的PCB用垂直的
4.IC基板印刷油面過程與PCB 也不同, PCB像是在屠宰場, 而IC基板卻要求在無塵室
5.IC基板的PAD通常用化金的方式, PCB要省錢用噴錫, 當然也有些是化金
6.IC基板的良率較低, 而PCB不到95%就準備收起來!
PCB印刷電路板以不導電材料(最早用電木後有玻璃籤維鋁板及軟塑化材料等)塗鍍上一層導電面(一般為銅膜),所製成的平板主要功用做電子線路的基板。
IC載板功能
IC 封裝主要提供IC保護、散熱、電路導通等功能,而測試則是 檢測所製造的IC功能是否正常。兩者除了功能不同外,在成本結構上也有差異。封裝業因設備投資金額不大,原料成本是製造成本的大宗,約佔4-6成左右,而 折舊所佔比重約1成多。尤其,隨著載板封裝的快速成長,因載板成本較貴,原料成本所佔比重更高。測試並不須投入原料,無原料成本,但固定成本高,因設備投 資金額大,因此使得折舊佔製造成本比重約4-5成。
隨晶圓製程技術演進,使得晶圓佈線密度、傳輸速率及訊號干擾等 效能需求提高,使得IC載板需求逐漸增加。IC載板是介於IC及PCB之間的產業,主要功能為承載IC做為載體之用,並以IC載板內部線路連結晶片與 PCB板之間訊號連結。因此在I C封裝中,IC載板逐漸形成一寡佔市場。
IC 載板內部有線路連接IC與電路板,用以溝通IC與電路板之 間訊號、保護電路與散熱的功能,一般用於較高階的封裝製程中。因此當高階封裝的比例上升的同時,IC載板與封裝產業的關係愈加密切,IC載板的重要性提 高。另外在電子產品朝輕薄短小、高效能與低功耗設計趨勢,覆晶載板之封裝方式將由現階段單晶片封裝型態演變為多晶片與整合型晶片封裝。
IC 載板的技術,主要分為IC與載板的連接方式,及載板與 PCB的連接方式。首先在IC與載板的連接方式,目前有分為覆晶載板(Flip Chip,FC)及打線載板(Wire Bounde,WB)。FC是將具有凸塊接點之IC晶片反貼覆置於承載基板上,該承載基板即稱為覆晶載板 (Flip Chip Substrate),係作為晶片與電路板間電性連接與傳輸的緩衝介面。透過載板的扇出 (Fan out)功能,以確定晶片邏輯閘 (Logic gate)輸出能達到電路板上邏輯閘輸入的最大數目。
WB 是利用金線 (Gold wire)連接IC晶片上之電性接點 (Electrical pad)與承載基板,該種特殊打線封裝方式下使用之載板即稱為打線載板 (Wire Bond Substrate),係作為晶片與電路板間之電性連接與傳輸的緩衝介面。透過載板的Fan out功能,以確定晶片邏輯閘 (Logic gate)輸出能達到電路板上邏輯閘輸入的最大數目。
FC 與WB相異處在於晶片與載板間連接以植球 (Solder bumps)方式取代金線,因植球能提高載板的訊號密度 (I/O port),並提升晶片效能表現,另外Bumping便於對位校正,有利增加封裝良率。因此,Flip Chip 載板無論在各項物理特性上皆優於Wire Bond 載板,相關應用將逐漸擴大,使得目前手機晶片廠商逐漸採用FC取代WB。
另外在載板與PCB的連接方式,因應用的不同,而分有針型陣列 封裝(Pin Grid Array; PGA) 、閘型陣列封裝(Land Grid Array; LGA) 、球型陣列封裝(Ball Grid Array; BGA)。PGA/LGA封裝主要是應用在微處理器方面,BGA則主要應用在繪圖晶片、北橋晶片、遊戲機晶片、高階ASIC晶片、數位電視晶片方面。
另外目前主要應用在手機晶片封裝的Chip Scale Packages (CSP) 是指封裝後的體邊長小於晶片邊長1.2倍的封裝型態。由於高階手機功能日益複雜,晶片I/O數持續增加,載板製程更要求高腳數、腳距更細密,因此封裝技術 也逐漸由打線走向FC CSP。目前全球主要手機晶片供應商持續增加晶片採用FC CSP的比重,包括Qualcomm、Broadcom、STMicroelectronics、Marvell等皆是,因此手機載板朝覆晶發展的趨勢不 變。
若以應用面來區分,CSP有超過70%都應用在手機上面,其它的應用則包括RF、基頻、記憶體IC以及PC周邊等。BGA則以PC相關為主,比重約佔30%,如基地台、伺服器、DVD、STB等亦多採用BGA封裝。FC則集中在CPU、GPU等需要大量運算的晶片上。
另外在IC載板方面,由於IC產品特色不同,如手機、通訊晶片、CPU、GPU、Chipset等,使得IC載板也有許多不同,如FC CSP、CSP、FBGA等,因IC載板的差異,使得製程困難度也不一。
Calpella平台
Calpella 平台為第六代Centrino平台代號,主要 特色是將原北橋晶片部份功能整合至CPU及南橋晶片中,使得北橋晶片消失。原北橋晶片的功能有4項功能,分別為記憶體控製(Memory Control) 、繪圖(Graphics) 、顯示(Display) 及管理(Management)。在新的Calpella平台中,記憶體控製(Memory Control) 及繪圖(Graphics) 功能移入CPU中,而將顯示(Display) 及管理(Management) 功能移入南橋晶片中。使得CPU 基板層數將由原本6 層提高至12 層,而南橋將由原本的WB 製程改為FC,若以IC載板的面積計算,面積增加了32.5%。Intel力推45nm(x66)及32nm(x68)製程及晶片組整合趨勢都是帶動FC 需求提昇的動能。
| 覆晶載板產品介紹與應用
產品定義
將具有凸塊接點之IC晶片反貼覆置於承載基板上,該承載基板即稱為覆晶載板 (Flip Chip Substrate),係作為晶片與電路板間電性連接與傳輸的緩衝介面。透過載板的扇出 (Fan out)功能,以確定晶片邏輯閘 (Logic gate)輸出能達到電路板上邏輯閘輸入的最大數目。與打線載板相異處在於晶片與載板間連接以植球 (Solder bumps)方式取代金線 (Gold wire),此舉能大幅提高載板的訊號密度 (I/O port),並提升晶片效能表現,為未來載板發展之趨勢。 
封裝方法
產品應用
|
IC與載板的連接方式:
載板與PCB的連接方式:
PGA/LGA封裝主要是應用在微處理器方面,BGA則主要應用在繪圖晶片、北橋晶片、遊戲機晶片、高階ASIC晶片、數位電視晶片方面。
產 品包括CSP(Chip Scale Package,晶片尺寸封裝)、BGA(Ball Grid Array,球閘陣列封裝)、FC(Flip Chip,覆晶)。CSP有超過70%都應用在手機上面,其它的應用則包括RF、基頻、記憶體IC以及PC周邊等。BGA則以PC相關為主,比重約佔 30%,如基地台、伺服器、DVD、STB等亦多採用BGA封裝。FC則集中在CPU、GPU等需要大量運算的晶片上。
CSP
BGA
FC
IC 載板產業的上游為基礎原料產業,包括銅箔、樹脂基板(銅箔基板)、乾膜(固式光阻劑)、
金鹽(金屬化合物)等主要原材料供應者;IC載板產業的下游為封裝產業,如國內的日月光、矽 品或是國外的Amkor等等。
基 板依其材質可分為BT與ABF兩種。採用BT材質的FC-BGA載板,毛利率在4成到5成左右;若採用ABF材質的FC-BGA,毛利率在20%到25% 之間 而生產BT樹脂材質 (wire bond)載板材料為主的日商三菱瓦斯化學、日立化成 (Hitachi Chemical)各佔全球市佔50%、40%。國內載板廠的產品結構來看,XX的BT樹脂載板佔營收比重高達80-90%,以應用於高階智慧型手機為 主,XX30-40%的比重,XX的比重則約10-15%。
由於高階手機功能更加複雜,晶片I/O數持續增加,載板製程更要求高腳數、腳距更細密,因此封裝技術也逐漸由打線走向FC CSP。
目前全球的IC載板100%都應用在封裝市場上,屬於高階封裝的1種,除了全球電子產品市場成長帶動之外,隨著電子產品複雜度、訊號傳輸量增加,對於封裝層次提升也是造成其成長的重要原因。
載板逐漸取代傳統SO及FP/CC等封裝型態,高階封裝由2007年佔全球封裝市場的28%,成長至2012 年的32%。上述趨勢顯示電子產品功能益趨複雜,相對應的封裝型式,必須要做相對應的進步,所以未來高階封裝佔整體封裝的比重會更提升。
目前全球IC載板生產國當中以日本為首,日本載板廠是全球載板客戶下單時的首要考量,不論是其通過認證情況、優秀製程能力以及相關材料產業支援能力,日本載板廠商所生產的載板優於其他國家廠商。
台灣為全球第2大生產國,受惠於台灣電子產業鏈完整,加上台灣擁有全球最大IC製造規模,對於下游載板及封裝會有相對應的需求。
此 外台灣IC載板廠商也透過向日本廠商技術授權,加上自身對於製程良率及技術控制性高,成為全球大廠下訂單時僅次於日本廠商的第2選擇。目前台灣載板廠已開 始試圖將技術層次較低的載板產品移至大陸進行生產,未來當地生產規模也有機會搭配當地電子產業鏈壯大,而挹注更強的成長力道。





























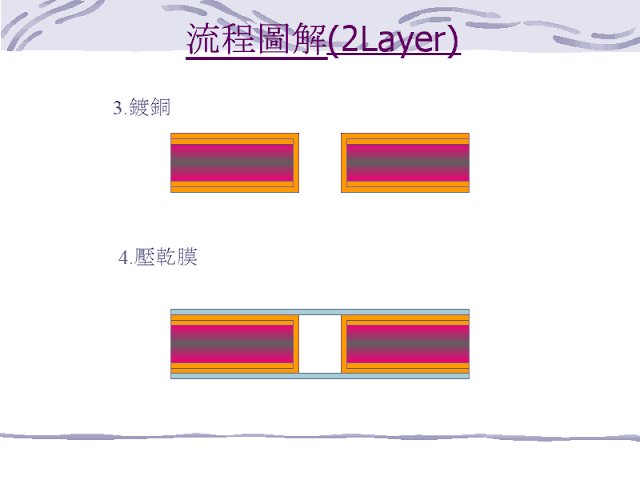





不錯介紹, 希望最後圖Ni/Au上錫球有後續~
回覆刪除讚! 鉅細靡遺的解說,很完整有系統
回覆刪除Good
回覆刪除謝謝你的解說
回覆刪除太棒了! 非常感謝啊
回覆刪除說明非常詳細,謝謝!
回覆刪除感謝解說!超棒!
回覆刪除